MEMS(メムス)
MEMSとは?
MEMSとはMicro Electro Mechanical Systems(微小電気機械システム)の略で、微小な立体構造(3次元構造)を持ち、様々な入力・出力信号を扱うシステムの総称です。
微細加工技術によって、機械要素部品,電子回路,センサ,アクチュエータが一つの基板上で集積化ができる高付加価値デバイスです。
MEMSプロセス
MEMSプロセスは、成膜工程、フォトリソグラフィ工程、エッチング工程など、一般的な半導体プロセスフローを基本としています。
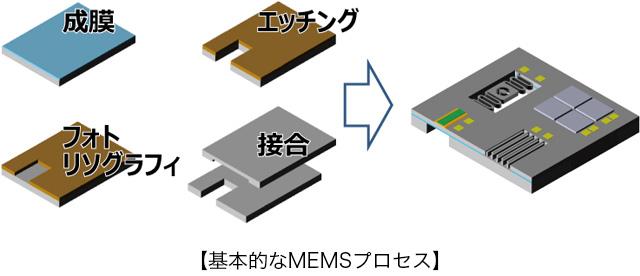
以下にMEMSプロセスにおけるキーテクノロジーを一部紹介します。
ウェハ
- SOIウェハ
- SOIとはSilicon On Insulatorの略語で、酸化膜上にシリコン単結晶層を形成したシリコンウェハのことをいいます。パワーデバイスやMEMSなどに幅広く応用されており、MEMSにおいては酸化膜層をシリコンエッチングのストッパー層として利用する事ができる事から、複雑な3次元立体構造の形成が可能となります。
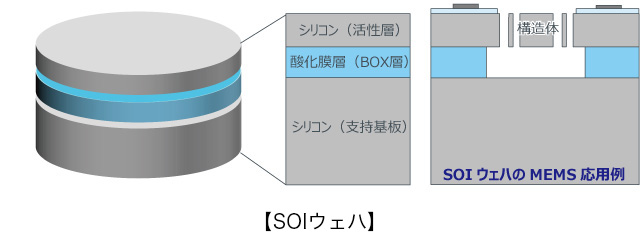
TAIKO研削 "TAIKO"は、株式会社ディスコの商標です
TAIKO研削とは、ディスコ社が開発したウェハを研削する際に、最外周のエッジを残し、その内側のみを研削する技術です。
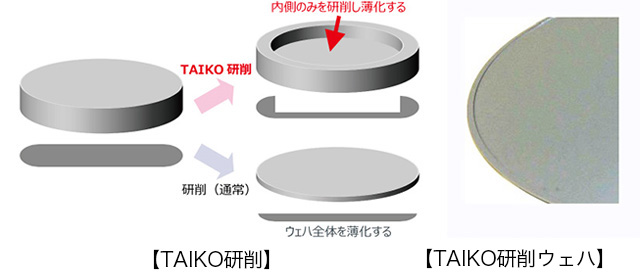
TAIKO研削は通常の研削に比べ、「ウェハ反りの低減」 「ウェハ強度向上」 「ハンドリングが容易」 「他プロセスとの整合性向上」 などの利点があげられます。
- ウェハ貼り合わせ/熱剥離シートプロセス
- サポートウェハと熱剥離シートを使用することにより、薄化ウェハのハンドリングなどが容易に行えます。

- ウェハ接合
- ウェハ接合は、大きく、「直接接合」と「中間層による接合」の2つに大別できます。
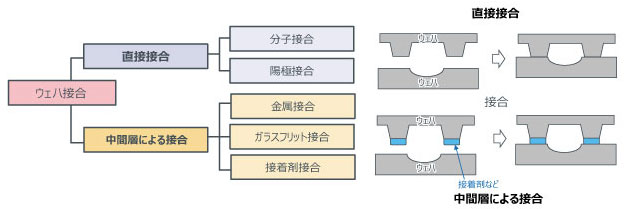
直接接合は接着剤などを使わずに、熱処理による分子間力でウェハ同士を貼り合わせる接合でSOIウェハを作る場合などに用いられます。
中間層による接合は、接着剤などを介してウェハ同士を貼合せる接合方法です。
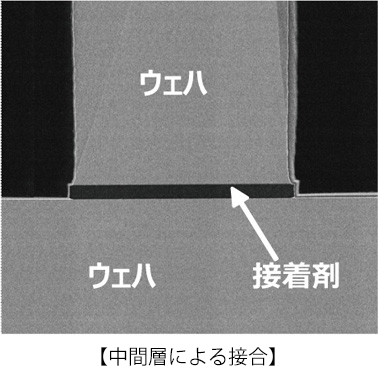
エッチング
- 等方向エッチングと異方性エッチング
- 低真空中の放電によりプラズマから発生するイオンなどの粒子でエッチングする技術を反応性イオンエッチングと呼びます。
プラズマ中には、電荷を持つイオンと中性のラジカルが混在しており、ラジカルによる等方性エッチング、イオンによる異方性エッチングの2つのエッチング作用があります。
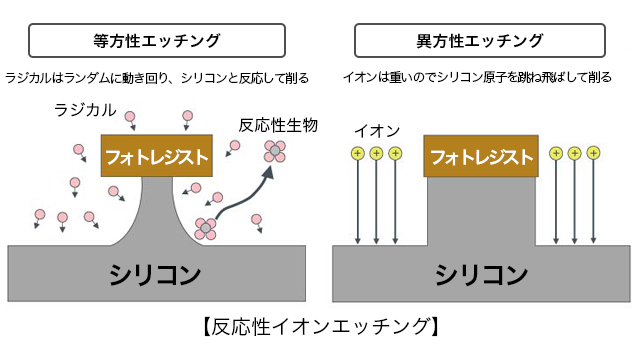
- シリコン深堀エッチング
- シリコン深堀エッチングは、異方性エッチングと等方性エッチングの長所を組み合わせたボッシュプロセス技術が主流技術となっています。
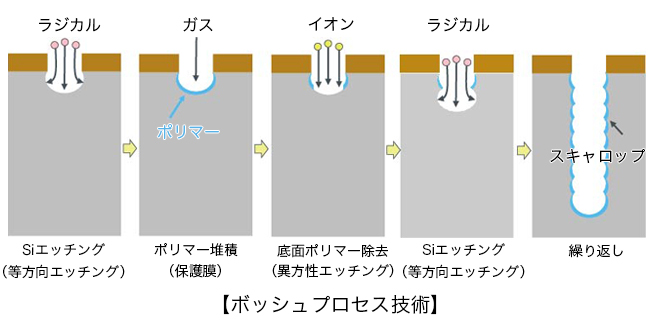
Siエッチング⇒ポリマー堆積⇒底面ポリマー除去 を繰り返すことで、縦方向の深堀エッチングが可能となります。
側壁の凹凸は、ほたて貝の殻に似ている事から、”スキャロップ”と呼びます。
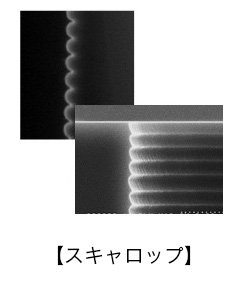
成膜
- ALD(原子層堆積)
- ALDはAtomic Layer Deposition(原子層堆積)の略語で、材料供給(プリカーサー)と排気を繰り返し、基板との表面反応を利用して原子一層ずつをステップで積み重ねる成膜方式です。
この方式は、成膜材料が通れる隙間があれば小さな穴の側壁や深い穴の底の部分などでもナノオーダーの膜厚制御で成膜することが可能で、深堀エッチング後の保護膜堆積などMEMS加工で均等な成膜を形成する事ができます。
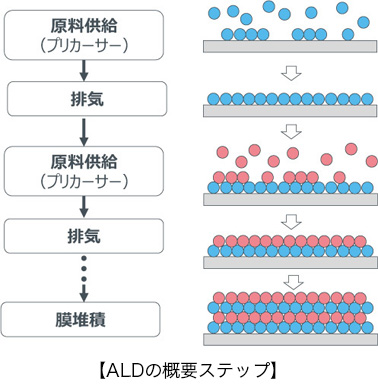
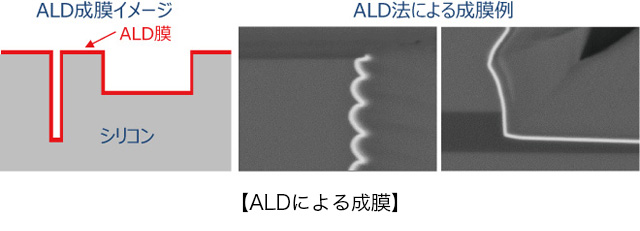
ロームの薄膜ピエゾMEMSファウンドリは、所有する最先端の薄膜ピエゾおよびLSI微細加工技術と豊富な量産実績を融合させることで、小型,省エネ,高性能な製品の実現を試作,開発から量産までをトータルサポートします。
次ページは、MEMSに関連する用語について簡単にまとめています。









